2026年初,电子产品的体积更小、功能更复杂:01005/0201微小封装、0.4mm甚至更细的Pitch、BGA/QFN等底部焊点器件在更多项目里成为常态。 这也意味着一个现实问题:同样是“贴片加工”,有的PCBA板子能稳定跑几年,有的出货后几周就出现偶发死机、断续接触、返修率高——背后往往不是设计“突然变差”,而是焊接缺陷(虚焊/连锡/立碑)没有被在生产过程中及时拦截。
本文从产品经理与采购最关心的“质量与良率”出发,拆解常见SMT品质痛点、对应的工艺根因,以及山西英特丽如何通过3D SPI检测 + 炉前/炉后AOI光学检测 + X-Ray透视检测构建“证据链式”的PCBA品质控制闭环,做到以0 PPM出货为目标的过程管理。
你可以先记住这三句话:
虚焊通常表现为焊点润湿不良、焊料未充分熔融或焊点结构不完整,导致电气连接时通时断。它常常不会在出厂时立刻暴露, 而是在运输震动、温度循环、长期工作后出现:例如“偶发死机”“轻按主板就恢复”“充电异常”“振动后重启”。
连锡是指相邻焊点之间被焊料桥接,形成短路。随着0.4mm Pitch(甚至更细)器件普及、走线更密,连锡不仅会造成“通电即死”, 还会引发过流发热、间歇短路等更隐蔽的风险。
立碑(Tombstone)多见于0201/0402等小型片式元件,两端受热不均、润湿力不平衡时,一端被“拉起”,导致开路或接触不良。 它不一定在所有板上出现,常表现为批次性/工况性问题,最容易“偶发”。
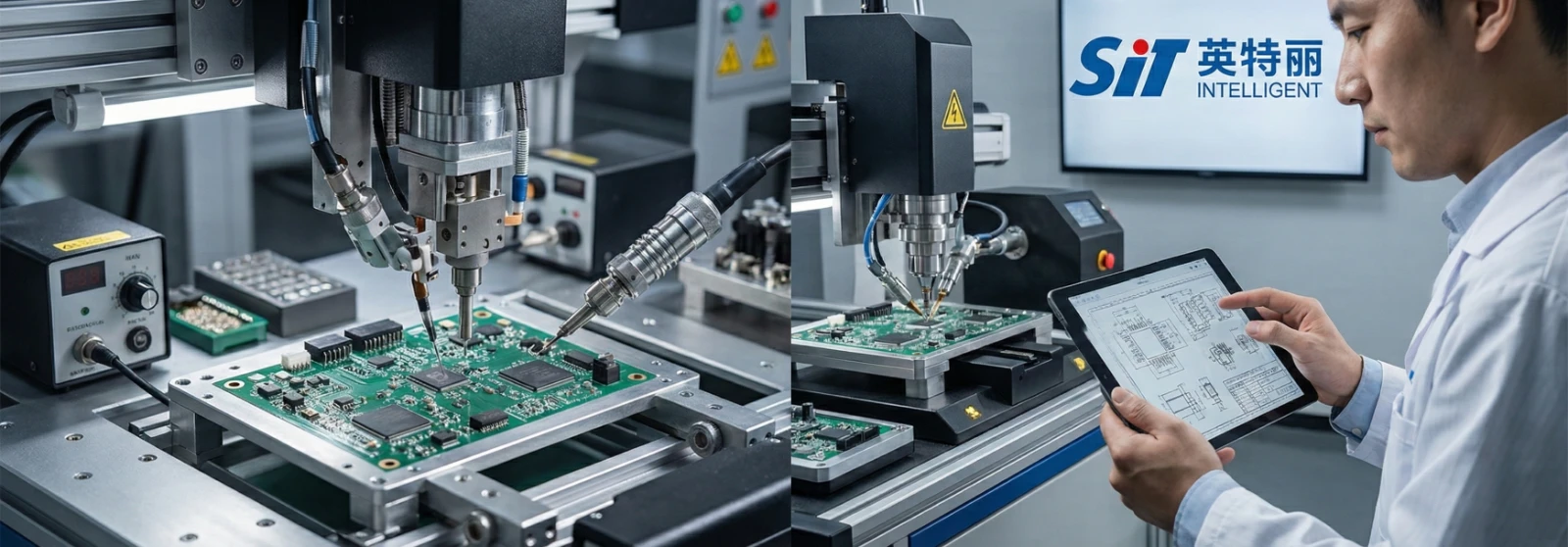
想真正解决“SMT虚焊原因”“连锡怎么解决”,不能只靠返修。正确方法是把缺陷分解到工艺链条中:锡膏 → 印刷 → 贴装 → 回流 → 检测 → 测试, 让每一个环节都有可量化的“闸门”。
进入01005封装与高密度板时代,贴装不再是“贴上去就行”。吸嘴选型、视觉对位、贴装压力、飞达稳定性都会影响焊点成形。 这也是为什么成熟的SMT贴片加工不仅看“有没有贴片机”,更看贴装平台的稳定性与工艺窗口管理能力。
即便是正规渠道物料,也可能因为储存、运输、开封、湿敏等级(MSL)管理不到位,出现可焊性下降或吸潮风险。 对工厂来说,物料管理能力是PCBA品质控制的一部分:入库检验、烘烤、真空防潮、先进先出都要可追溯。
先说明:“0 PPM”不是一句口号,而是一套从源头预防、过程拦截到出货验证的体系目标。我们把它落实为“每一块板、每一道关”的检测闭环, 让质量管理从“经验判断”变成“数据与图像证据”。
在SMT中,锡膏印刷是缺陷的最大来源。我们采用3D SPI对锡膏的体积(Volume)/高度(Height)/面积(Area)进行量化检测, 将“锡量过多导致连锡”“锡量过少导致虚焊”尽可能拦截在贴片之前。

炉前AOI聚焦贴装质量:漏贴、错贴、偏移、极性、翻件等问题会在回流前被发现,避免把缺陷“焊死”到板上。 对01005/0201等微小元件而言,炉前拦截对良率提升非常关键。
回流后通过AOI对焊点外观、桥连、少锡、多锡、偏移等进行筛查,快速覆盖大部分可见焊点缺陷。 对于“连锡怎么解决”,AOI的价值在于:发现快、定位快、返修闭环快,避免批量流出。
AOI看不见的地方(BGA/QFN/LGA底部焊点、局部遮挡区域),必须依赖X-Ray检测做透视判断, 重点关注:桥连、虚焊、空洞(Void)、焊球偏移等。通过图像留存与标准判定,确保关键器件焊接质量受控。
如果你曾被“良率承诺”伤过,建议把沟通从“口头保证”升级为“可交付的证据”。下面这份清单能显著降低沟通成本:
补充建议(2026常见新需求):如果你的产品面向车载、工控、新能源或高端消费电子,建议把关键器件(BGA、电源、连接器、晶振) 列成“关键特性清单”,明确每一项的检测方式与抽检比例,避免上线后才补救。
A:在量产场景里,最常见来自“锡膏/印刷/回流曲线”组合问题,其次是物料可焊性与湿敏管理。用3D SPI把锡膏参数量化,是降低虚焊最有效的手段之一。
A:AOI主要基于外观与形貌判断,能覆盖大部分可见焊点异常,但对BGA/QFN底部焊点或“电气接触不稳定”的隐蔽虚焊,仍需要X-Ray与电测/功能测试配合。
A:优先从锡膏印刷(钢网开口/厚度/对位)与SPI判定阈值入手,再结合炉后AOI快速拦截。对于细Pitch器件,适当“减锡”通常比单纯调回流更直接。
A:贴装平台稳定性、视觉对位能力、工艺窗口管理(含吸嘴/飞达/贴装压力/回流曲线)以及炉前AOI拦截能力。01005不是“能贴上”,而是“能长期稳定贴”。
A:可以。即便是OEM(客户提供Gerber/BOM/坐标),我们也会给出DFM/工艺风险提示,并用SPI/AOI/X-Ray把关键缺陷在过程内拦截,降低返修与售后成本。
对“被代工厂坑过质量”的客户而言,真正的安心来自三件事:设备硬实力、流程可追溯、问题响应快。 山西英特丽作为源头EMS工厂,围绕PCBA品质控制建立了稳定的交付体系:
延伸阅读:如果你还在评估“找工厂做OEM还是ODM更合适”,可参考 ODM与OEM的区别是什么?电子产品代工模式深度解析。
需要了解英特丽的服务能力范围,可查看 产品与服务,或直接联系工程师沟通需求。
了解更多 PCBA 制造知识,帮助您做出更好的决策